电子设备行业专题研究:玻璃通孔(TGV)为硅通孔(TSV)有效补充,AI+Chiplet趋势下大有可为东方财富证券2023-09-18.pdf





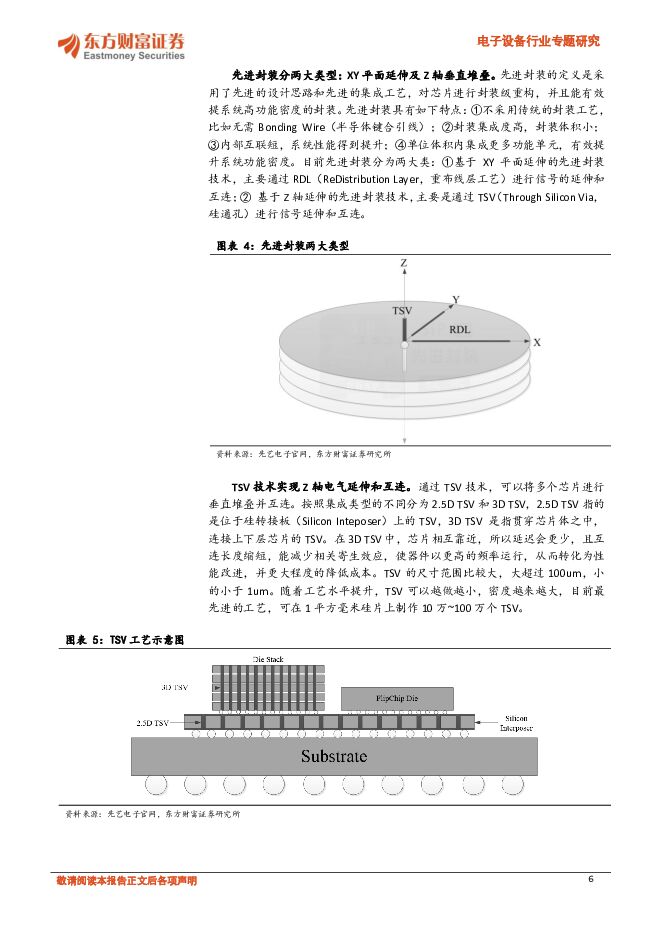
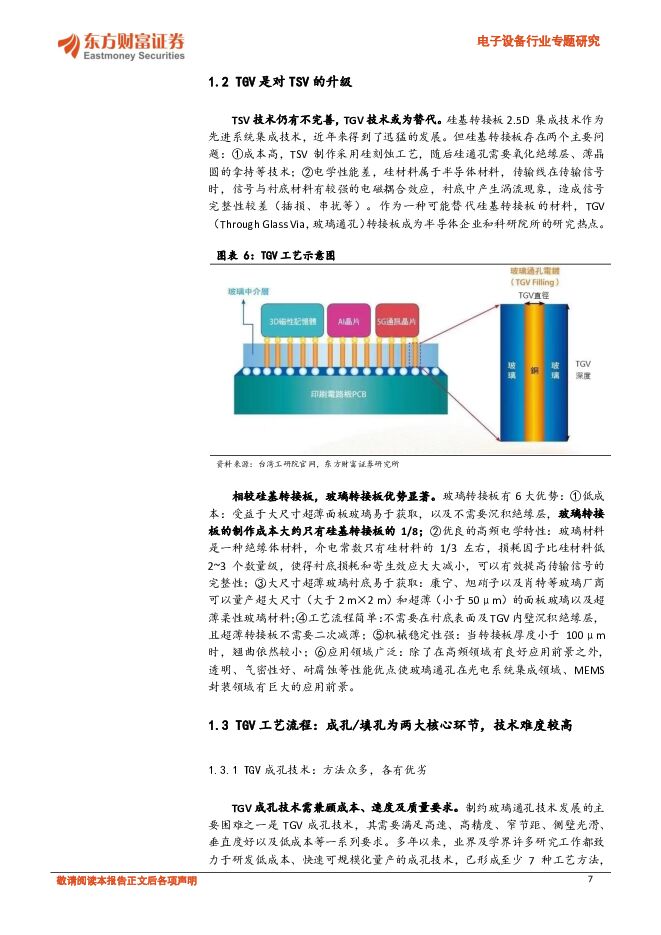

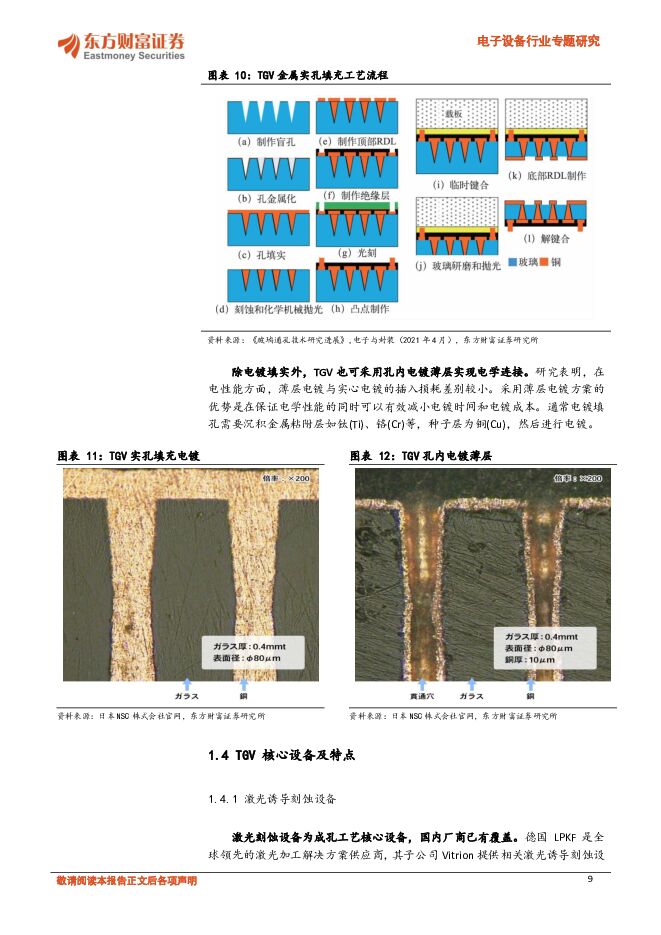

摘要:【投资要点】先进封装延续摩尔定律,TSV日渐触及瓶颈,TGV有望填补不足。随着摩尔定律接近尽头,2.5D/3D先进封装应运而生,其中转接板发挥着重要作用。目前,硅转接板及硅通孔TSV已相对比较成熟,在实际生产中广泛应用。然而硅是半导体材料,高频电学性能差,影响芯片性能。玻璃材料介电性能优良,热膨胀系数与硅接近,可规避上述问题。且TGV无需制作绝缘层,降低了工艺复杂度和加工成本。因此TGV及相关技术有望填补TSV技术的不足,在2.5D/3D封装、射频、微机电系统等领域有广泛应用前景。TSV在AI芯片封装一骑绝尘,需求高增为TGV打开成长空间。目前英伟达H100、AMDMI300、壁仞科技BR100等新一代AI芯片均采取以TSV为核心CoWoS封装。国内沃格光电则大力推进TGV技术在高算力服务器领域的应用。由于TGV对TSV存在一定优势,TGV有望在部分场景下替代TSV,进而成为AI时代先进封装核心演进方向之一,叠加大模型推动之下加速计算芯片需求高增,TGV远期成长空间广阔。玻璃芯载板长期潜力巨大,假以时日或与ABF分庭抗礼。除玻璃转接板外,TGV另一重要应用为玻璃芯载板。AI+Chiplet风潮之下产业转向大尺寸封装及小芯片设计,封装材料要求与日俱增。主流ABF载板尚有一定缺陷,其粗糙表面会对精细电路性能产生负面影响。可能作为替代的玻璃芯载板表面更光滑且厚度更小,使芯片性能提高、功耗下降。目前已有玻璃芯载板+TGV产品问世,为AI相关等芯片封装提供高性能/低功耗/小外形尺寸的差异化优势。尽管大规模商业化尚需时日,但其有望成为载板行业的规则改变者,未来或与ABF并驾齐驱。多领域潜力释放+传统工艺替代升级,TGV未来可期。除逻辑芯片外,TGV及玻璃基板在LED、微机电系统、封装天线、集成无源器件等领域也有不同程度应用进展。LED方面,玻璃基材料及TGV技术充分契合MIP封装,随着MicroLED渗透提速,市场潜力巨大;MEMS领域,TGV技术早在多年前已导入设计制造环节,国际大厂均有玻璃基产品推出;封装天线方面,TGV+FOWLP有望为天线封装开辟新路径,无线通信及汽车雷达需求可期,此外集成无源器件中TGV也有广泛应用。【配置建议】建议关注TGV工艺及产品供应商沃格光电、赛微电子、蓝特光学等。建议关注TGV工艺流程中激光诱导刻蚀设备供应商帝尔激光、大族激光及镀铜设备供应商盛美上海。【风险提示】受消费市场影响,下游需求不及预期;关键性技术难度大,研发不及预期;TGV产能供给不及预期。
免责声明: 1.本站部分作品是由网友自主投稿和发布、编辑整理上传,对此类作品本站仅提供交流平台,不为其版权负责。 2.如发布机构认为违背了您的权益,请与我们联系,我们将对相关资料予以删除。 3.资源付费,仅为我们搜集整理和运营维护费用,感谢您的支持!
合集服务: 单个细分行业的合集获取请联系行研君:hanyanjun830
-
通信行业周报2024年第17周:北美云厂加大AI投入,运营商一季度经营稳健 国信证券 2024-04-28(37页) 附下载

核心观点行业要闻追踪:北美云厂2024一季度经营业绩表现亮眼,AI投入持续提升。Meta、微软、谷歌...
2.16 MB共37页中文简体
2小时前020积分
-
有色金属行业周报:美或陷入滞胀金价上涨趋势不变,有色板块虽有回调但逻辑不改,继续推荐金铜铝 华福证券 2024-04-28(15页) 附下载

投资要点:贵金属:美或陷入滞胀,金价上涨趋势不改。本周美联储降息预期延后叠加中东冲突双方相对克制,金...
2.27 MB共15页中文简体
2小时前220积分
-
通信行业周报:海外云巨头财报总结:AI对营收贡献逐渐显著,资本开支持续增长,AI投资有望实现正循环 开源证券 2024-04-28(18页) 附下载

AI相关资本开支持续增长,AI对营收贡献逐渐显著,有望实现投资正循环META发展AI雄心不减,再次上...
1.99 MB共18页中文简体
2小时前020积分
-
通信:CXL高速互联:破解AI时代“内存墙”新途径 国联证券 2024-04-28(11页) 附下载

AI时代“内存墙”问题愈发明显AI大模型的快速发展推动“算力”和“存力”需求快速增长,与此同时,对“...
928.94 KB共11页中文简体
2小时前020积分
-
偏光片行业深度:大陆面板厂商份额提升趋势明确,偏光片国产替代需求扩大 东吴证券 2024-04-26(17页) 附下载

投资要点春江水暖:面板复苏趋势明朗,产能持续向大陆转移:在需求端复苏和供给缩减的共同作用下,面板价格...
4.68 MB共17页中文简体
2小时前020积分
-
2024年趋势追踪:矿业及金属行业面临全球性挑战与机遇 德勤 2024-04-26(69页) 附下载

步入2024年,矿业及金属行业面临一系列错综复杂的挑战和机遇、预期及需求。随着能源转型、全球城市化和...
4.88 MB共69页中文简体
2小时前020积分
-
互联网电商行业专题研究:生成式AI重塑广告营销产业链,商业化落地加速 国联证券 2024-04-28(16页) 附下载

生成式AI助力互联网广告市场持续增长我国互联网广告市场增速持续回升,生成式AI加速渗透。2023年,...
1.6 MB共16页中文简体
2小时前020积分
-
建筑材料2024Q1公募持仓点评:建材行业占比7年新低,玻璃、玻纤关注度有所提升 华安证券 2024-04-26(10页) 附下载

主要观点:公募持仓:建材行业占比7年新低,玻璃、玻纤关注度有所提升①我们选取公募基金前十大重仓股票作...
379.49 KB共10页中文简体
2小时前020积分
-
电子行业周报:华为重夺中国大陆智能手机市场第一 华安证券 2024-04-28(21页) 附下载

主要观点:本周行情回顾从指数表现来看,本周(2024-04-22至2024-04-26),上证指数周...
2.89 MB共21页中文简体
2小时前220积分
-
氟化工行业周报:巨化股份、金石资源一季度业绩大幅增长,制冷剂、萤石趋势上行态势不变 开源证券 2024-04-28(22页) 附下载

本周(4月22日-4月26日)行情回顾本周氟化工指数上涨3.01%,跑赢上证综指2.25%。本周(4...
2.25 MB共22页中文简体
2小时前020积分
-
传媒行业周报:Vidu引领国内视频模型再突破,继续布局AI应用 开源证券 2024-04-28(20页) 附下载

国内视频大模型“Vidu”震撼发布,继续布局多模态AI应用4月27日,生数科技联合清华大学正式发布中...
2.69 MB共20页中文简体
2小时前020积分
-
非银金融行业:财政发力,政策积极,非银或现趋势性机会 信达证券 2024-04-28(15页) 附下载

本期内容提要:核心观点:政策面上,高层定调将进一步优化国有金融资本布局,集中力量打造金融业“国家队”...
1.52 MB共15页中文简体
2小时前020积分
-
电子周观点:微软&谷歌业绩超预期,AI产业趋势确定性增强 信达证券 2024-04-28(11页) 附下载

本周申万电子细分行业普涨。申万电子二级指数年初以来涨跌幅分别为:半导体(-15.31%)/其他电子Ⅱ...
1002.88 KB共11页中文简体
2小时前020积分
-
电子4月周专题:真AI PC落地有望刺激PC换机需求 国联证券 2024-04-28(12页) 附下载

真AI PC落地提供全新本地化AI体验2024年4月18日,联想举办创新科技大会,推出本地AI助理联...
995.99 KB共12页中文简体
2小时前020积分
-
电子行业AI PC:触手可及的个人AI助理,2024 AI ON蝶变开启在即 德邦证券 2024-04-26(15页) 附下载

投资要点:AI PC是什么:从视频会议、智能助手开始,成长为个人AI助理。联想与IDC将AI PC的...
1.06 MB共15页中文简体
2小时前020积分
-
电子:德州仪器Q1业绩超预期,持续关注模拟芯片板块 德邦证券 2024-04-26(2页) 附下载

投资要点:事件:4月24日,德州仪器发布2024Q1财务业绩。Q1业绩超预期,公司预计Q2营收持续增...
347.66 KB共2页中文简体
2小时前220积分
-
传媒:AI板块底部修复,关注优质标的 国投证券 2024-04-26(3页) 附下载

事件:商汤自4.23发布日日新大模型5.0后获得市场积极反馈,4.24-4.26日3天股价涨幅分别为...
316.55 KB共3页中文简体
2小时前020积分
-
传媒:港股内容平台的“AI进攻性机会” 华福证券 2024-04-28(2页) 附下载

投资要点:一、随着AI技术逐步引入到AI内容创作过程中,按照AI内容制作的难易程度,AI内容正在从“...
313.47 KB共2页中文简体
2小时前020积分
-
旭光电子 三大业务稳健成长,氮化铝应用有望加速 国投证券 2024-04-28(8页) 附下载

旭光电子(600353)事件:4月26日,公司发布2024年一季报,单季度实现收入3.87亿元,同比...
1.1 MB共8页中文简体
2小时前218积分
-
易德龙 汽车电子业务增速亮眼,全球化发展加速 国投证券 2024-04-28(5页) 附下载

易德龙(603380)事件:公司发布2023年年报及2024年一季报,2023年实现营业收入19.1...
913.39 KB共5页中文简体
2小时前018积分




