走进“芯”时代系列之七十六—HBM之“设备材料”深度分析:HBM迭代,3D混合键合成设备材料发力点华金证券2024-03-04.pdf




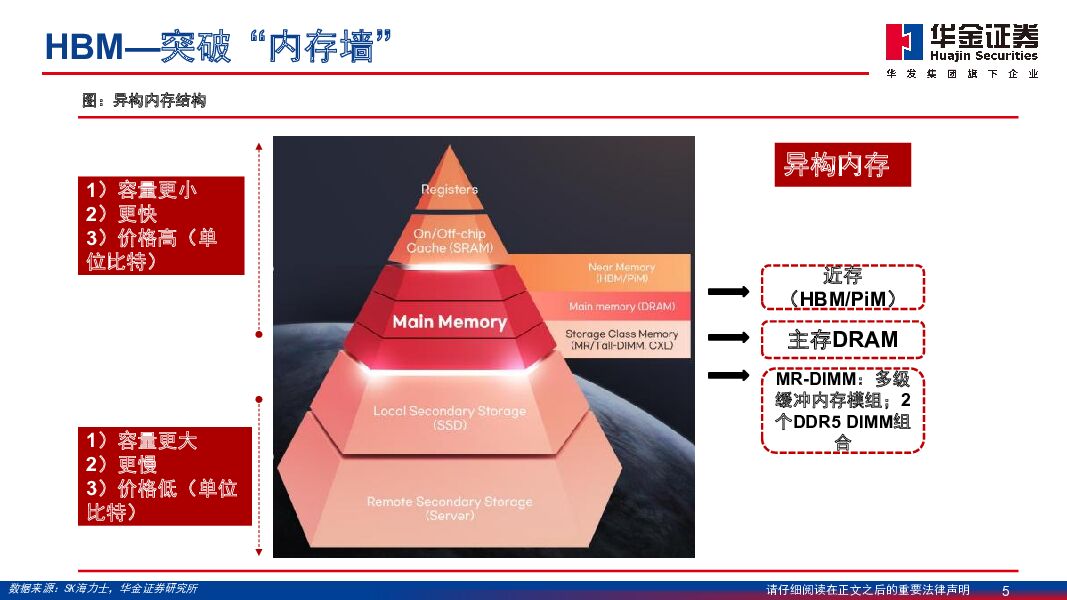

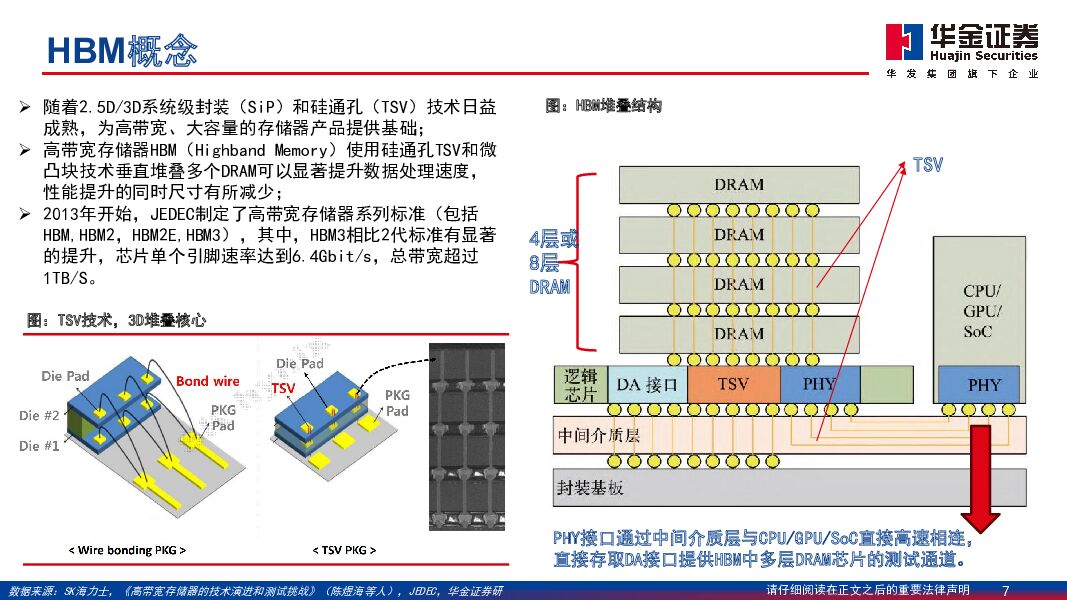

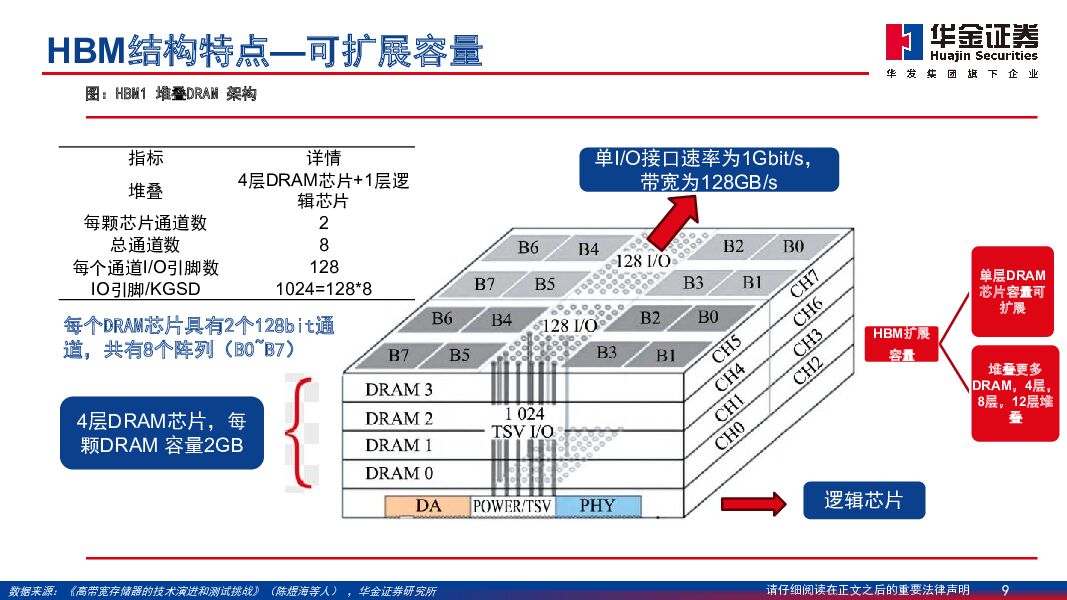
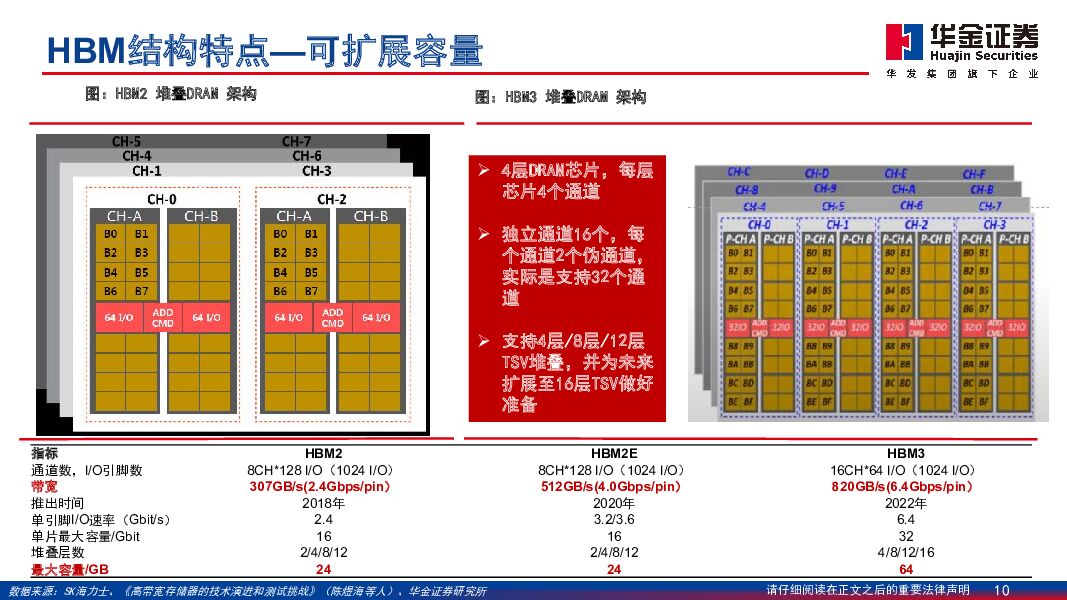
摘要:HBM加速迭代,市场空间足:HBM突破“内存墙”,实现高带宽高容量,成为AI芯片最强辅助,我们认为HBM将持续迭代,I/O口数量以及单I/O口速率将逐渐提升,HBM3以及HBM3e逐渐成为AI服务器主流配置,且产品周期相对较长,单颗容量及配置颗数逐步增加,预计HBM4于2026年发布。2024年全球HBM市场有望超百亿美元,市场空间足,国产供应链加速配套。HBM3海力士率先引入MR-MUF,HBM4剑指混合键合:当前HBM采用“TSV+Bumping”+TCB键合方式堆叠(TSV一般由晶圆厂完成,封测厂可在堆叠环节进行配套),但随着堆叠层数的增加散热效率很差,TCB不再满足需求,海力士率先引入MR-MUF回归大规模回流焊工艺,芯片之间用液态环氧模塑料作为填充材料,导热率比TC-NCF中的非导电薄膜高很多,但海力士也预计HBM4会引入混合键合Hybrid Bonding方案,取消互连凸块。我们预判当前HBM主流依然是TCB压合,MR-MUF方案为过渡方案,未来混合键合是大趋势。液态塑封料LMC依然是晶圆级封装至关重要的半导体材料之一。混合键合与TSV是3D封装的核心,HBM“连接”与“堆叠”带来设备材料端发展新机遇:混合键合分为晶圆对晶圆W2W和芯片对晶圆D2W,3D NAND使用W2W,典型案例为长鑫存储的Xstacking,CMOS层+存储层采用W2W混合键合方案,预计HBM未来亦会采用W2W方案,W2W与D2W方案相比一般应用于良率非常高的晶圆,避免损失。根据我们产业链研究,混合键合将充分带动永久键合设备与减薄+CMP需求,根据BESI官方数据,预计存储领域未来贡献混合键合设备明显增量,保守预计2026年需求量超过200台,减薄+CMP亦成为重要一环。当前HBM方案主要带动固晶机、临时键合与解键合、塑封装备以及TSV所需的PECVD、电镀、CMP等设备;材料端则是TSV电镀液、塑封料等。相关标的:包括封测环节:通富微电(先进封装)、长电科技(先进封装)等;设备环节:拓荆科技(PECVD+ALD+键合设备)、华海清科(减薄+CMP)、华卓精科(拟上市,键合设备)、芯源微(临时键合与解键合)等;材料环节:华海诚科(环氧塑封料)、天承科技(RDL+TSV电镀添加剂)、艾森股份(先进封装电镀)等风险提示:行业与市场波动风险,国际贸易摩擦风险,新技术、新工艺、新产品无法如期产业化风险,产能扩张进度不及预期风险,行业竞争加剧风险。
免责声明: 1.本站部分作品是由网友自主投稿和发布、编辑整理上传,对此类作品本站仅提供交流平台,不为其版权负责。 2.如发布机构认为违背了您的权益,请与我们联系,我们将对相关资料予以删除。 3.资源付费,仅为我们搜集整理和运营维护费用,感谢您的支持!
合集服务: 单个细分行业的合集获取请联系行研君:hanyanjun830
-
食品饮料24Q1持仓分析:白酒加仓食品减仓,盐津铺子首入前20 华金证券 2024-04-25(13页) 附下载

投资要点基金持仓情况:行业环比加仓,市值缩水但超配提升。(1)行业整体:食品饮料行业加仓,环比提升同...
3.44 MB共13页中文简体
2天前020积分
-
云天化 资源优势凸显经营韧性,财务质量持续优化 华金证券 2024-04-25(7页) 附下载

云天化(600096)投资要点事件:云天化发布2024Q1和2023财报,24Q1公司实现营收138...
333.3 KB共7页中文简体
2天前018积分
-
亿纬锂能 出货量高速增长,应用场景不断拓展 华金证券 2024-04-25(5页) 附下载

亿纬锂能(300014)投资要点事件:公司发布2023年度财报和2024年一季报,2023年实现营业...
322.49 KB共5页中文简体
2天前018积分
-
晶科能源 组件龙头地位稳固,N型技术持续领跑 华金证券 2024-04-25(5页) 附下载

晶科能源(688223)投资要点事件:晶科能源发布2023年年报。报告期内,公司积极应对行业周期波动...
304 KB共5页中文简体
2天前018积分
-
传音控股 Q1业绩超预期,持续看好新兴市场开拓及品类扩张 华金证券 2024-04-25(5页) 附下载

传音控股(688036)事件点评:公司发布2024年第一季度报告,报告期内,公司实现营收174.43...
306.37 KB共5页中文简体
2天前018积分
-
加仓有色、通信,减仓医药、计算机 华金证券 2024-04-25(13页) 附下载

一季度整体仓位下降,主板持仓占比明显上升,创业板和科创板仓位回落。首先,2024Q1主动偏股型基金整...
3.29 MB共13页中文简体
2天前010积分
-
通灵股份 23年盈利能力持续改善,全球市场空间广阔 华金证券 2024-04-24(5页) 附下载

通灵股份(301168)投资要点事件:公司发布2023年年度报告与2024年一季报,2023年全年,...
293.37 KB共5页中文简体
3天前218积分
-
通灵股份 23年盈利能力持续改善,全球市场空间广阔 华金证券 2024-04-24(5页) 附下载

通灵股份(301168)投资要点事件:公司发布2023年年度报告与2024年一季报,2023年全年,...
293.37 KB共5页中文简体
3天前018积分
-
颀中科技 24Q1业绩同比高增,AMOLED占比稳步提升 华金证券 2024-04-24(5页) 附下载

颀中科技(688352)投资要点公司发布2023年年度报告和2024年第一季度报告。24Q1业绩同比...
305.96 KB共5页中文简体
3天前018积分
-
颀中科技 24Q1业绩同比高增,AMOLED占比稳步提升 华金证券 2024-04-24(5页) 附下载

颀中科技(688352)投资要点公司发布2023年年度报告和2024年第一季度报告。24Q1业绩同比...
305.96 KB共5页中文简体
3天前018积分
-
阳光电源 光储行业龙头地位稳固,持续推进产品服务全球覆盖 华金证券 2024-04-24(5页) 附下载

阳光电源(300274)投资要点事件:公司发布2023年年度报告,2023年全年,公司实现营业收入7...
306.42 KB共5页中文简体
3天前018积分
-
阳光电源 光储行业龙头地位稳固,持续推进产品服务全球覆盖 华金证券 2024-04-24(5页) 附下载

阳光电源(300274)投资要点事件:公司发布2023年年度报告,2023年全年,公司实现营业收入7...
306.42 KB共5页中文简体
3天前018积分
-
霍莱沃 营收稳健利润承压,延伸布局低空及卫星赛道 华金证券 2024-04-24(7页) 附下载

霍莱沃(688682)投资要点事件:2024年4月23日,霍莱沃发布2023年度报告,2023年公司...
303.79 KB共7页中文简体
3天前018积分
-
霍莱沃 营收稳健利润承压,延伸布局低空及卫星赛道 华金证券 2024-04-24(7页) 附下载

霍莱沃(688682)投资要点事件:2024年4月23日,霍莱沃发布2023年度报告,2023年公司...
303.79 KB共7页中文简体
3天前218积分
-
浙文互联 营销质效全面提升,数字文化生态初步建立 华金证券 2024-04-23(5页) 附下载

浙文互联(600986)投资要点事件:公司2023年实现营业收入108.18亿元,同比减少26.59...
302 KB共5页中文简体
4天前218积分
-
甬矽电子 产品矩阵持续丰富,积极布局尖端先进封装 华金证券 2024-04-23(5页) 附下载

甬矽电子(688362)投资要点23年产/销量同比增长超30%,24年规模效应有望提升或为盈利贡献正...
314.43 KB共5页中文简体
4天前218积分
-
扬杰科技 “MCC+YJ”双品牌运作,车规SiC模块已获合作意向 华金证券 2024-04-22(5页) 附下载

扬杰科技(300373)投资要点2024年4月21日,公司发布2023年年度报告。全年光伏二极管/S...
308.83 KB共5页中文简体
5天前218积分
-
金徽酒 2024Q1开局稳健,产品结构升级延续 华金证券 2024-04-22(5页) 附下载

金徽酒(603919)事件:公司发布2024年一季报,24Q1公司实现营业收入10.76亿元,同比增...
294.42 KB共5页中文简体
5天前218积分
-
食品饮料行业周报:3月社零增速放缓,关注财报业绩催化 华金证券 2024-04-21(15页) 附下载

投资要点上周回顾:上周食品饮料(申万)行业整体上涨0.74%,在31个子行业中排名第10位,跑输上证...
1.36 MB共15页中文简体
6天前520积分
-
通信行业周报:运营商智算采购启动,首个通感一体低空专网落地 华金证券 2024-04-20(23页) 附下载

投资要点1、本周回顾本周通信(中信)下跌0.43%,同期上证指数上涨1.52%,深证成指上涨0.56...
540.18 KB共23页中文简体
6天前520积分




